1.封装发展历程
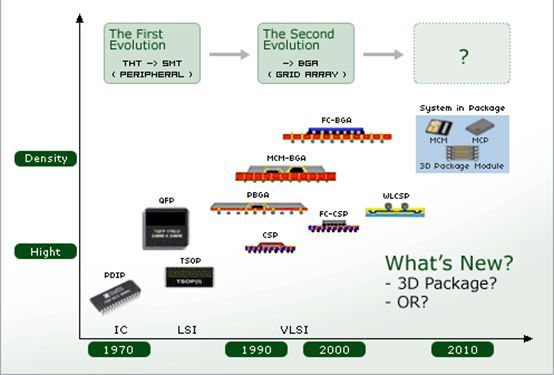
进入正式讨论之前,我们先来前戏。
对于封装,从低级到高级,都是一个芯片(IC)+壳(Package)。
受限于工艺限制,早期的设计是芯片封装后,通过引脚,连接到线路板上。
90年代随技术进步及消费需求,BGA横空出世。
最大的进步,是封装四周的引脚连接改进为封装底部锡球连接,极大提高利用面积利用率。
2. 2DIC与SiP

哈哈,说好的好好讨论,废话了好多基础知识。不过学而时习之,不亦乐乎嘛。
90年代后的发展,结构基本一样。CSP、WLP等进一步缩小引脚尺寸,提高组装密度。
2D IC发展到极致的封装如图,其芯片面积和封装面积比已经达到极限。

既然小标题都剧透2D了,那自然还有3D IC。这图中的IC堆叠方式虽然已经开始利用空间,然而仍然显得不怎么高级。

毕竟这里只能堆叠相同功能的芯片,而且还有各种连线飞来飞去。金玉其外败絮其中有些夸张,好歹到这一步,已经比2D开始有革*命性的突破了。
3. 初级3D IC SIP


上图,中介硅层当作被动原件,少了败絮;
下图,两个不同芯片互连。
4.完全体模型

不解释。就问你怕了没有。这只是个模型哦。
不过不要怕,这种完全体的真身目前看来还是浮云。
注:不要看这些图画的跟汉堡一样厚,实际上中介层的厚度一般都只有0.2mm-0.7mm,整个封装实际上非常非常非常小。
| 产品型号 | 产品描述 | 通知日期 | 生效日期 |
|---|---|---|---|